芯粒异构集成给半导体行业带来一次重大升级,能有效解决芯片设计制造中的诸多瓶颈。然而,高密度集成在降低算力芯片成本的同时也面临功耗显著增加、散热困难等技术挑战,热管理成为提升芯片性能的关键问题。如何针对芯粒异构集成的复杂性,提出新的热仿真方法,这对Chiplet热管理技术提出了新的要求。
针对以上问题,微电子所EDA中心多物理场仿真课题组构建了芯粒集成三维网格型瞬态热流仿真模型,能够实现Chiplet集成芯片瞬态热流的高效精确仿真,为芯粒异构集成温度热点检测和温感布局优化奠定了核心技术基础。同时,课题组在集成芯片电热力多物理场仿真方面进行布局,开展了直流压降、热应力和晶圆翘曲仿真等研究工作。
近期,课题组在Chiplet热仿真工具方面取得新进展。通过对重布线层(RDL)、硅通孔(TSV)和凸点阵列进行各向异性等效,构建了从GDS版图到系统级封装的跨尺度各向异性热仿真模型,在提升仿真模型精度的同时优化了集成芯片温度热点检测方法。同时,构建了芯粒异构集成电热耦合仿真模型,支持复杂互连结构物性参数等效,实现了电热双向耦合高效计算,可准确描述集成芯片焦耳热效应下的温度变化行为。此外,基于以上模型和算法研究进展,将热仿真方法拓展至更大尺度,自主研发了晶圆级热仿真模拟器。该模拟器能够为芯粒异构集成芯片提供更大尺度的热仿真分析,同时支持散热器流体动力学模型设计,仿真结果更接近实际应用场景的潜在温度热点预测,有助于优化热设计仿真流程。与有限元方法相比,模拟器单元数量减少了2.78倍,运行时间减少了25.9倍,相对误差为0.38%。目前,课题组与国内知名企业开展了热仿真关键技术合作,相关模型和算法正在进行应用验证。
以上研究得到了中国科学院战略性A类先导专项、国家自然科学基金重大研究计划、国家重点研发计划、中国科学院青年交叉团队等项目支持,研究成果先后发表在热力学顶级期刊《Applied Thermal Engineering》 (A wafer-scale heterogeneous integration thermal simulator, DOI:10.1016/j.applthermaleng.2025.125459) 和微电子系统权威期刊《IEEE Transactions on Very Large Scale Integration (VLSI) Systems》(A multiscale anisotropic thermal model of chiplet heterogeneous integration system, DOI:10.1109/TVLSI.2023.3321933;An electrical-thermal co-simulation model of chiplet heterogeneous integration systems, DOI: 10.1109/TVLSI.2024.3430498)上。微电子所研究生王成晗、马晓宁为上述论文第一作者,微电子所徐勤志研究员和李志强研究员为上述论文通讯作者。

图1 各向异性热仿真
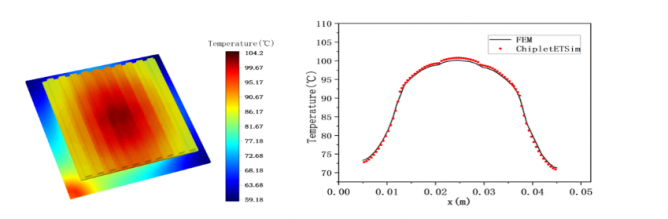
图2 电热耦合仿真

图3 热仿真模拟器
(来源:中国科学院微电子研究所i)
